| 2022年6月22日 |
較小電子產品的金票((Nanowerk新聞)大阪大學靈活的3D係統集成實驗室的科學家開發了一種新的方法,用於使用銀的直接三維粘結,使用銀,這可以降低新電子設備的成本和能源需求。這項工作可能有助於設計下一代智能設備,這些智能設備更緊湊並且使用較少的電力。 |
| 這項研究是“通過壓力,低溫和大氣應力遷移鍵合的直接鍵合3D集成包裝”,在EEE 72nd電子組件和技術會議(ECTC)中介紹了這項研究。 |
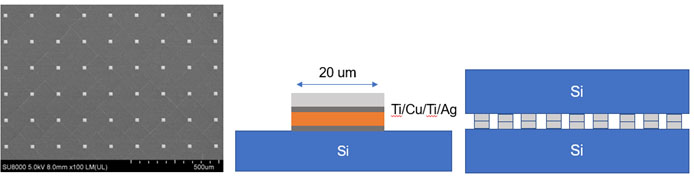 |
| 圖1(右)製造的20 µm Cu-ag凸起的SEM圖像,(中間)準備的凸起橫截麵的示意圖,(左)鍵合20 µm Cu-ag ag bump設備的示意圖。(圖片:Katsuaki Suganuma) |
| 三維綜合電路在電子設備中起著越來越重要的作用。與傳統的2D電路相比,這些架構可以節省空間並減少互連電線所需的材料。但是,與在常規集成電路中使用的成熟技術相比,形成可靠的3D連接的能力需要新的方法。 |
| 現在,大阪大學的一組研究人員展示了如何使用銀層直接連接銅電極“顛簸”。 |
| 第一作者張張說:“我們的過程可以在柔和的條件下,在相對較低的溫度下進行,而不會增加壓力,但是鍵可以承受超過1000個循環的熱震動,從-55到125ºC。” |
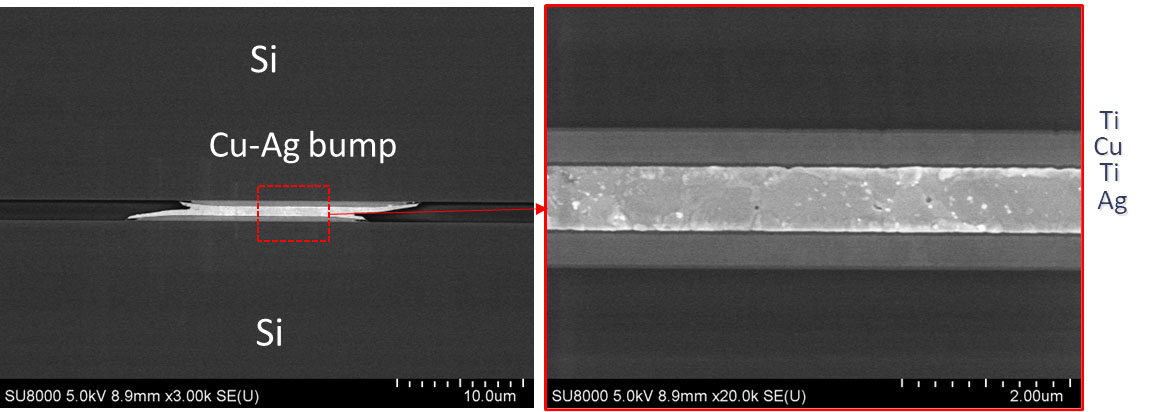 |
| 圖2。(右)鍵合的Cu-ag顛簸的橫截麵圖像,(左)鍵合Cu-Ag樣品界麵的放大視圖。(圖片:Katsuaki Suganuma) |
| 在這種新方法中,首先將銀濺到以在室溫下粘合的兩個銅表麵。然後,將熱量施加到退火時,在稱為“應力遷移”的過程中導致表麵發生微觀變化。退火期間的應力釋放導致表麵粗糙,這確保了兩個銀層之間的足夠有效麵積。 |
| 結果,即使在比較的低退火溫度下,也可以在沒有施加壓力的情況下完成鍵合。這種方式隻需十分鍾即可實現長達20微米的永久連接。此過程還需要中等溫度(180°C),並且可以在大氣條件下工作。 |
| 該團隊能夠使用掃描電子顯微鏡和原子力顯微鏡的圖像來確認被濺射和退火的芯片的表麵粗糙度。 |
| 高級作家Katsuaki Suganuma說:“這項技術有望為具有高密度的互連和高級3D包裝的芯片做出貢獻。” |